-
新闻资讯
- 激光应用
- 行业资讯
- 久恒风采
销售热线:17758118083
电话:0577-66871553
邮箱:sale@highlaser.cn
1688网店:https://laser2015.1688.com
总公司地址:浙江省瑞安市阁巷新区东二路138号32幢

机遇与挑战
近年来,随着5G、电动汽车、物联网、AI、云计算等发展,砷化镓、氮化镓、碳化硅等非硅半导体材料备受关注,新材料、下游终端的研发与应用也逐步被重视,芯片生产线的投放量增加,预示封测产业拥有着较大的市场空间。这给企业带来诸多机遇,同时也面临着诸多挑战。目前国内封测产业链尚不健全,对国外设备、材料具有很强的依赖性,装备及材料的国产化水平亟待提高。从去年的中兴事件,到今年的华为事件,国内企业都感受到芯片自给自足的重要性、建设半导体产业链的必要性和迫切性。
激光技术在先进封装领域的应用
1、激光解键合技术
2017年,全球12寸薄片晶圆出货量超7500万片;2011年至2017年,每年的增幅在15%左右。随着元器件朝着小型化、超薄化的发展中,传统的加工装备以及传统的加工工艺很难满足高精度的加工需求。面向超薄器件加工领域,大族显视与半导体推出紫外激光解键合方案。
紫外激光解键合技术通过光路整形得到固定大小的激光光斑,利用振镜或平台对玻璃晶圆面进行扫描加工。使得release层材料失去粘性,最终实现器件晶圆和玻璃晶圆的分离。
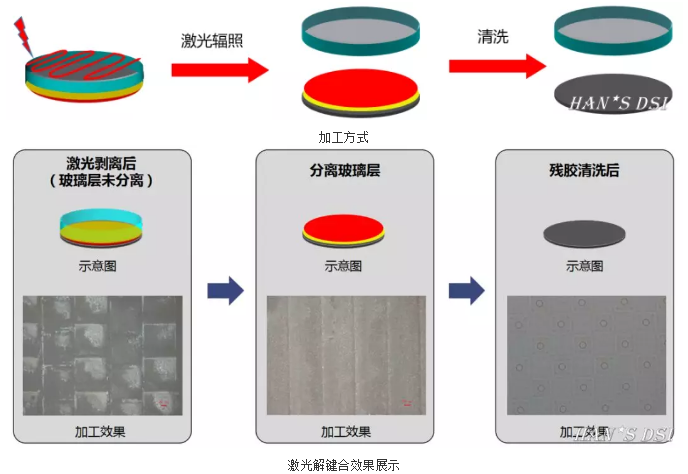
2、激光开槽技术
在对表面具有low-k材料的半导体晶圆进行切割分片时,如果采用传统的刀轮切割方案,极易在low-k层产生崩边、卷翘和剥落等不良;而采用非接触式的激光加工方案则可以有效避免上述问题。
通过光路系统将光斑整形成特定的形貌,聚焦于材料表面达到特定槽型;并利用超快激光极高的峰值功率,将材料从固态直接转化成气态,从而极大的减少热影响区,是一种先进的激光冷加工工艺制程。
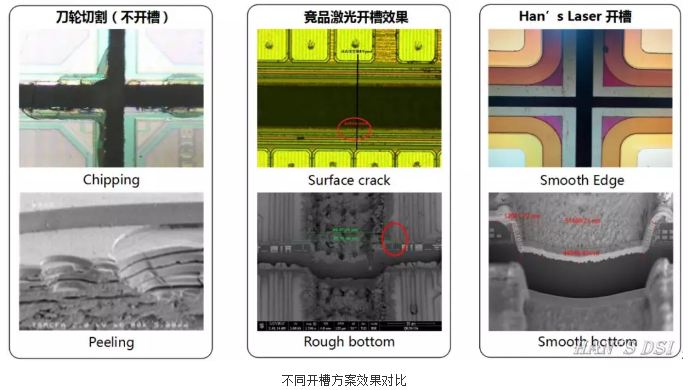
3、激光改质切割技术
激光改质切割技术适用于硅、碳化硅、蓝宝石、玻璃、砷化镓等材料。通过将激光束聚焦在晶圆衬底层内部,通过扫描形成切割用的内部“改质层”,再通过劈刀或真空裂片使相邻的晶粒断裂。
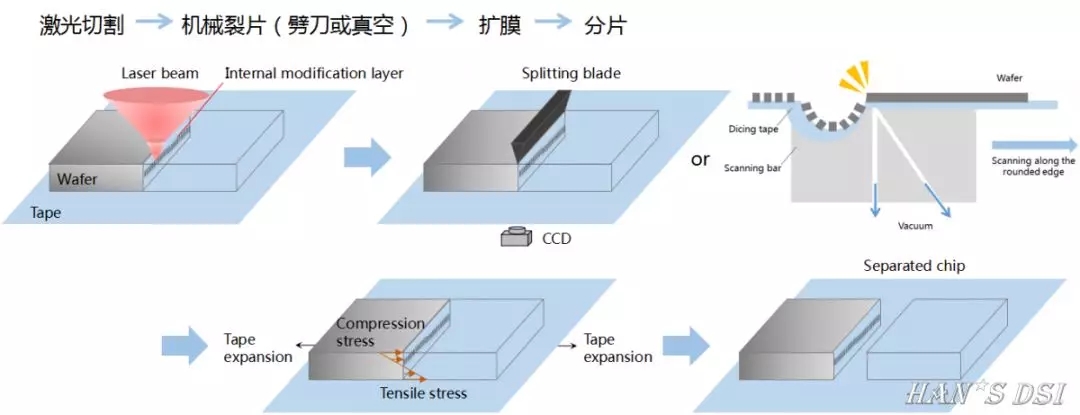
激光改质切割流程
激光改质切割的激光切割宽度几乎为零,有助于减小切割道宽度;在材料内部进行改质,可以抑制切割碎屑的产生,无需涂胶清洗工序。在切割过程中,采用DRA自动对焦,焦点实时跟随片厚变化而自动调整,确保改质切割的激光聚焦改质层深度一致。
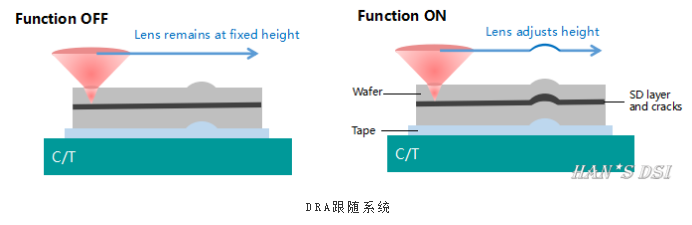
4TGV技术
TGV 技术是通过在芯片与芯片之间、晶圆与晶圆之间制作垂直电极,实现电信号从密封腔内部垂直引出的工艺。技术广泛应用于 MEMS 圆片级真空封装技术领域,在气密性、电学特性、封装兼容性与一致性以及可靠性方面独具优势,是实现 MEMS器件微型化、高度集成化的有效方式。
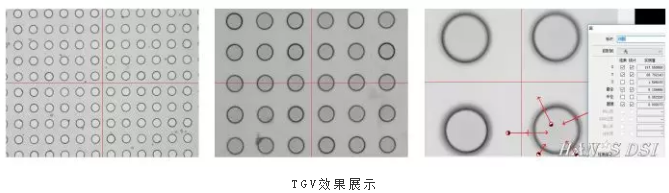



 当前位置:
当前位置: